底部填充Underfill點膠機 人人天天日日夜夜狠狠干半導體芯片封裝設備
發表時間:2021-10-21

Underfill點膠(jiāo)工藝被用於電子零(líng)件(jiàn)的批量製造。它有助於穩定和加固焊點,並提高精(jīng)密元件(jiàn)耐受溫度循環的(de)性(xìng)能,有助於防止機械疲勞,延長組件的使用壽命。
為了使便攜式設備(bèi)變得更輕、更小和更可靠,製造商們麵臨著(zhe)以上諸多難題。在這些產(chǎn)品中(zhōng)應用Underfill點膠工藝有助於提高精密元器件的性(xìng)能,並保證卓越的(de)產品(pǐn)質量。
底部填充封裝(zhuāng)點(diǎn)膠(jiāo)工藝類別
CSP 封(fēng)裝——近年來,芯(xīn)片級封裝 (CSP) 的應用(yòng)迅速普及(jí)。CSP 最常用於電子裝配。底部填充膠常用於提高 CSP 與電路板(bǎn)之間連接的機械強度,確保 CSP 滿足機械衝擊(jī)和彎曲要求。
BGA 封裝——許多製造商(shāng)使用 BGA 封裝(zhuāng)底部(bù)填充膠來加固焊點和提高產品的抗振(zhèn)性和耐熱衝擊強度。
WLCSP封裝——底部填(tián)充膠可以顯著提高晶圓片級芯片規模封裝 (WLCSP) 的耐跌落性(xìng)能和耐熱循環性能。這有助於延長 WLCSP 的使用壽命。
LGA 封裝——平麵網格陣列封裝 (LGA) 元(yuán)件也可從(cóng)底部填(tián)充膠的使用中獲益(yì)。底(dǐ)部填充膠有助於增強 LGA 的機械強度和(hé)可靠性。
邊角封裝——用於四角或邊緣粘合的底部填充膠比標準的毛細流動解決方(fāng)案具有更高的觸變性,當以點膠或噴膠方式用於封裝外部時,可強化(huà)粘(zhān)合效果。漢高不僅(jǐn)提供全麵的毛細流動型材料解決方案(àn),而(ér)且還涵蓋用於邊緣和四角等的半加(jiā)固解決方案。
它是如何工作的?
底部填充膠在 BGA 組件和電路板之間提(tí)供了牢固(gù)的(de)機械粘合,以增加抗振(zhèn)性並減(jiǎn)少熱(rè)應力(lì)損壞。
 1. 助焊劑分配:將受(shòu)控量的助焊劑材料分配到芯片和基板之(zhī)間的間隙中。
1. 助焊劑分配:將受(shòu)控量的助焊劑材料分配到芯片和基板之(zhī)間的間隙中。
2. 芯片(piàn)放置:將芯片對準基板。
3. 回流焊:通過回流焊爐運行組裝。
4. 助焊劑清洗:清除殘留的助焊劑殘留物。
5. 底部填充膠點膠:將底部填充膠點膠到基板上。
6. 底部填充固化:在烘箱中對底部(bù)填充進行(háng)熱固化(huà)。
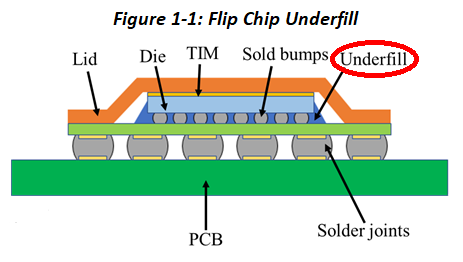
上圖是現代倒裝(zhuāng)芯片封裝,使用厚銅蓋進(jìn)行散熱。底部填充膠是一種關鍵組件,可防止焊料凸(tū)點(diǎn)在組裝和操作過程中(zhōng)受到熱應力和封裝翹曲的影(yǐng)響,以及防止芯片和低 k 層破裂。底部(bù)填充物充當芯片和基板之間的結構部件,並提供負載共(gòng)享,從而減(jiǎn)少焊點承受的應力。
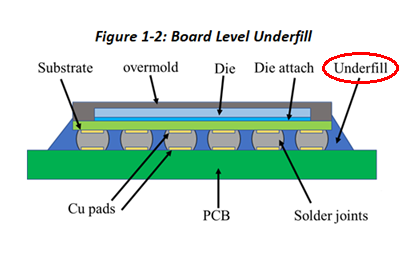
上圖是傳統的過模壓倒裝芯片封裝,其中板級焊點未填充。
方法(fǎ)
三種點膠方式排列:



Underfill點膠工藝用於各種封裝和板級組件,而 歐力克(kè)斯 點膠(jiāo)機,尤其是(shì) 壓電(diàn)噴射式點(diǎn)膠技術,可以可(kě)靠且可重複地為所有類型的封裝進行快(kuài)速、高效、完整的底部填(tián)充。底部(bù)填充(chōng)膠(jiāo)在倒裝芯片、板上直接芯片連接(jiē)、堆疊芯片封裝(zhuāng)和各種球柵陣列 (BGA) 組件下分配和流動,一旦固化,這些組件(jiàn)就會穩定下來。


最小噴射點徑0.2mm
最小噴射線(xiàn)徑0.3mm
最快(kuài)工作頻率1000Hz
Underfill 點膠設備
歐力(lì)克斯點膠機